
《微电子学概论》--Chap04
94页1、第第 四四 章章集成电路制造工艺集成电路制造工艺l 集成电路的制造需要非常复杂的技术,它主要由 半导体物理与器件专业负责研究。VLSI设计者可 以不去深入研究,但是作为从事系统设计的工程师 ,有必要了解芯片设计中的工艺基础知识,才能根 据工艺技术的特点优化电路设计方案。对于电路和 系统设计者来说,更多关注的是工艺制造的能力, 而不是工艺的具体实施过程。l 由于系统芯片SOC(System On Chip)的出现,给IC 设计者提出了更高的要求,也面临着新的挑战:设 计者不仅要懂系统、电路,也要懂工艺、制造。学习工艺的必要性集成电路设计与制造的主要流程框架设计芯片检测单晶、外 延材料掩膜版芯片制 造过程封装测试系统需求包括功能设计、逻辑设计 、电路设计、掩膜版图设 计、计算机仿真(后面章 节讨论)。集成电路的设计过程:设计创意 + 仿真验证集成电路芯片设计过程框架From 吉利久教授是功能要求行为设计(VHDL)行为仿真综合、优化网表时序仿真布局布线版图后仿真否是否否是Sing off 设计业制造业芯片制造过程AA直拉单晶硅由氧化、淀积、离子注入或蒸 发形成新的薄膜或膜层曝 光刻 蚀硅片
2、测试和封装用掩膜版 重复 20-30次集成电路芯片的显微照片集成电路的内部单元集成电路的内部单元( (俯视图俯视图) )N沟道MOS晶体管CMOS集成电路(互补型MOS集成电路): 目前应用最为广泛的一种集成电路,约占 集成电路总数的95%以上。4.1 集成电路制造工艺 图形转换:将设计在掩膜版(类似于照相底片)上的图形转移到半导体单晶片上 掺杂:根据设计的需要,将各种杂质掺杂在需要的位置上,形成晶体管、接触等 制膜:制作各种材料的薄膜一、图形转换:光刻光刻三要素:光刻胶、掩膜版和光刻机 ?光刻胶又叫光致抗蚀剂,它是由光敏化合物、基体树脂和 有机溶剂等混合而成的胶状液体。光刻胶是对光、电子束 或者x线等敏感,具有在显影液中溶解性变化的性质 ,同时具有耐腐蚀性的材料。光刻胶有正型和负型 两种。正型光刻胶受紫外线照射,其感光的部分发 生光分解反应溶于显影液,末感光的部分显影后仍 然留在基片的表面。与此相反,负型光刻胶的未感 光的部分溶于显影液中,而感光部分显影后仍留在 基片表面。 ?光刻胶受到特定波长光线的作用后,导致其化学 结构发生变化,使光刻胶在某种特定溶液中的溶解 特性改变 正胶:分
3、辨率高,在超大规模集成电路工艺中,一般只 采用正胶 负胶:分辨率差,适于加工线宽3m的线条正胶:曝光 后可溶负胶:曝光 后不可溶光刻工艺流程示意图光刻工艺(Photolithography)将电路图形转移到晶片上Design = Mask (掩膜) = Wafer(晶片)光刻需要的掩模CMOS电路版图和断面构造版图 Layout掩模 MaskCMOS工艺中使用的掩模 (与左图对应)IC由不同层次的材料组成的。每一层上的图形各不 相同。在每一层上形成不同图形的过程叫光刻。版图由代表不同类型“层”的多边形组成。在IC工艺中制作每一层时,都需要用掩模板来确定 在什么位置进行掺杂、腐蚀、氧化等。光刻是定域 半导体面积的一种手段。在此确定的面积上,进行 工艺加工。光刻的目的就是在二氧化硅或金属薄膜上面刻蚀出 与Mask上完全对应的几何图形,从而实现选择性掺 杂、腐蚀、氧化等目的。光刻工序:光刻胶的涂覆爆光显影刻蚀去胶光刻的基本要素是掩模板和光刻胶。三种光刻方式二、几种常见的光刻方法 ? 接触式光刻:分辨率较高,但是容 易造成掩膜版和光刻胶膜的损伤。 ? 接近式曝光:在硅片和掩膜版之间 有一个很小
4、的间隙(1025m),可以大 大减小掩膜版的损伤,分辨率较低 ? 投影式曝光:利用透镜或反射镜将 掩膜版上的图形投影到衬底上的曝光方 法,目前用的最多的曝光方式三、超细线条光刻技术 ?甚远紫外线(EUV) ?电子束光刻 ?X射线 ?离子束光刻经过光刻后在光刻胶上得到的图形并不是 器件的最终组成部分,光刻只是在光刻胶上形成 临时图形。为了得到集成电路真正需要的图形, 必须将光刻胶上的图形转移到硅片上。完成这种 图形转换的方法之一就是将未被光刻胶掩蔽的部 分通过选择性腐蚀去掉。常用的腐蚀方法分为湿法刻蚀和干 法刻蚀四、刻蚀技术 湿法刻蚀:利用液态化学试剂或溶 液通过化学反应进行刻蚀的方法 干法刻蚀:主要指利用低压放电产 生的等离子体中的离子或游离基(处于 激发态的分子、原子及各种原子基团等 )与材料发生化学反应或通过轰击等物 理作用而达到刻蚀的目的1. 湿法腐蚀:利用液态化学试剂或溶液通过化学反应进 行刻蚀的方法,用在线条较大的IC(3m); 优点:选择性好;重复性好;生产效率高 ;设备简单;成本低; 缺点:钻蚀严重;对图形的控制性差; 广泛应用在半导体工艺中:磨片、抛光、 清洗、腐蚀;2
《《微电子学概论》--Chap04》由会员野鹰分享,可在线阅读,更多相关《《微电子学概论》--Chap04》请在金锄头文库上搜索。

基本概念交流材料 莱阳一中刘辛凤2

2013届高考化学第一轮考点总复习课件5 溶液与胶体

2.1物质的分类

直流远供电源系统

直流电机及单相电机

电路分析(相量法)

机械制造技术第3章 -- 机械零件加工方法与设备

电荷及其守恒定律(经典)
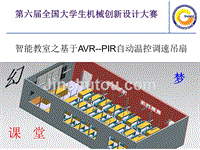
机械创新-幻·梦课堂

电气识图及其标准解读

电工技能培训讲堂1

电子商务物流成本管理

电压表电路连接练习1011 - 副本

生物:第7章《现代生物进化理论》课件(新人教版必修2)

生本课堂教学模式

物理:16.2《探究电动机的转动原理》课件1(沪粤版九年级下)

物理选修3-2第一章第1节教学课件

物理化学电子教案9

物理化学 08章_电解质溶液

工业机器人发展及应用
 大班韵律 忐忑 课件
大班韵律 忐忑 课件
2023-11-14 7页
 人教版六年级下册数学课件四、2比例的基本性质
人教版六年级下册数学课件四、2比例的基本性质
2023-02-28 15页
 Linux第三章
Linux第三章
2023-02-20 60页
 ch7振幅调制与解调
ch7振幅调制与解调
2023-02-20 52页
 部编版语文三年级下册训练题之修改符号修改病句
部编版语文三年级下册训练题之修改符号修改病句
2023-01-31 8页
 部编版小学语文六年级上册《只有一个地球》说课稿课件
部编版小学语文六年级上册《只有一个地球》说课稿课件
2022-12-27 23页
 经验分享工作培训动态PPT模板
经验分享工作培训动态PPT模板
2022-11-29 36页
 管理培训课件:龟兔赛跑解析
管理培训课件:龟兔赛跑解析
2022-11-28 41页
 企业复工与新冠病毒防护攻略(详细)
企业复工与新冠病毒防护攻略(详细)
2022-11-16 26页
 建筑施工大型设备设施安全管理
建筑施工大型设备设施安全管理
2022-11-09 71页

